光刻完成后对没有光刻胶保护的晶圆部分进行刻蚀,最后洗去剩余光刻胶,就实现了半导体器件在晶圆表面的构建过程。通常在蚀刻过程中以及刻蚀过程后,涉及到对晶圆基底厚度的测量,红外干涉传感器便是合适的测量方案。
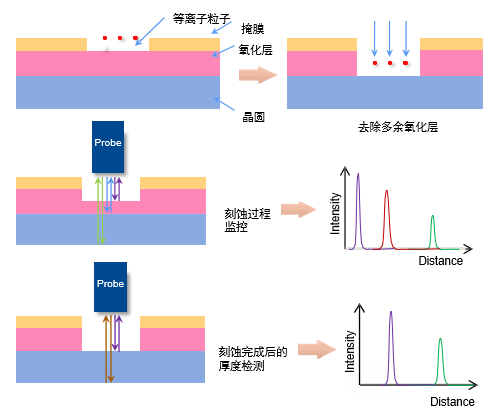


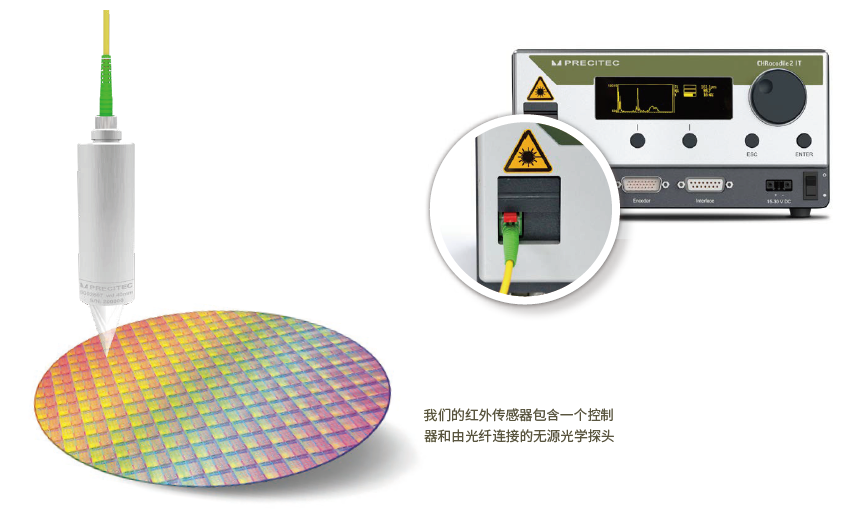
光干涉法测量透明体厚度原理
使用与光谱共焦相同的白光作为光源,配上特殊的探头,也可以利用光谱仪的配置来测量玻璃/薄层的厚度。当光投射到薄层的表面(玻璃/薄层厚度在 2μm 到 250μm 之间),反射光会产生干涉图样并被传感器接收。
通过计算反射信号的傅里叶变换,传感器能以最大 66,000 次每秒的速度捕捉多层材料的厚度。此测量方法适用于液体和固体材料,能够测量玻璃、流体或薄膜厚度,甚至空气层厚。
光干涉法测量非透明体厚度原理
使用红外光光源和特殊探头,类似硅或塑料之类的不透明材料也能被测量。根据从物体两个(或多个)表面反射回来的光信号,能够通过干涉图样计算出厚度。如果样本有许多层,每层的单独厚度和总厚度都能被算出。由于探头不含任何电子元件或移动部件,在做流水线测量时非常可靠,不受潮湿,酸性或不干净的环境因素影响。