硅通孔 Through Silicon Via(简称 TSV),是指通过铜、钨、多晶硅等导电物质的填充,在芯片和芯片之间、晶圆和晶圆之间制作垂直导通,实现硅通孔的垂直电气和芯片之间互连,是目前最新的 2.5D/3D 先进封装技术之一。可有效的减小互联长度,减小信号延迟,降低电容/电感,实现芯片间的低功耗,高速通讯,增加宽带和实现器件集成的小型化。
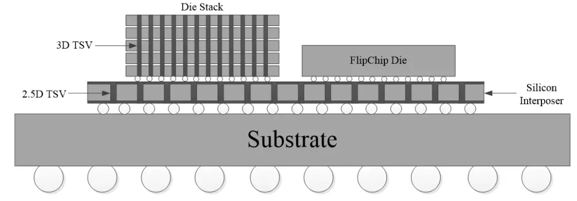
TSV 工艺可分为先通孔、中通孔和后通孔,然后进行导材料的填充。在此工艺过程中,为控制减薄移除量(先通孔和中通孔工艺)或是控制填充量,就需要测量 TSV 孔深度。
针对晶圆上密集的 TSV 孔,目前主要采用少量点数抽测的方式。普雷茨特红外干涉技术为该检测需求提供了点测以及面测两种解决方案,可测孔深比 1:25(仅针对已测样品 10 μm 孔径,250 μm 孔深,以及 5 μm 孔径 75 μm孔深),可测表面可视孔位置以及隐于 wafer 中的孔深(借助红外相机定位孔位置)。

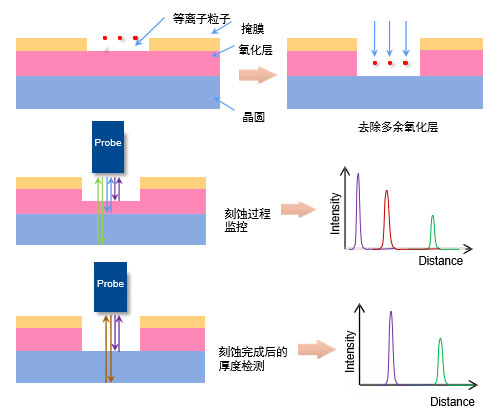
① CHRocodile 2 IT 系列
普雷茨特的高分辨率同轴干涉点传感器可在 2μm 至 17,700μm 的测量范围内进行非接触式距离和厚度测量。其纳米分辨率使其也可用于测量微结构,例如晶片上的微结构。另一个优点是,一次测量可同时测定多个单独层的厚度。
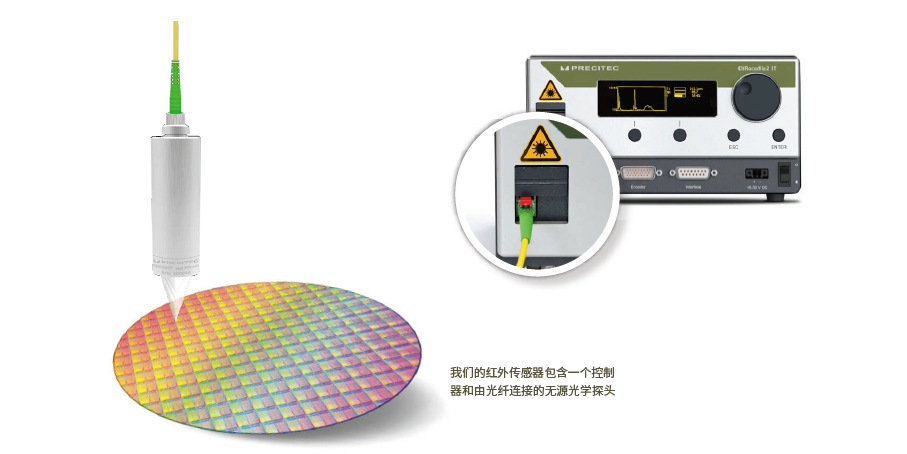
借助相机定位 TSV 位置,可测量表面可视及不可视位置 TSV 深度。

② 飞点扫描仪 FSS 系列
普雷茨特最新的光学探头与 CHRocodile 传感器 的结合使用使高速光学相干断层扫描成像在厚度和形貌检测中的应用成为可能。为在线和离线质量监控和 3D 检测提供的尖端技术可用于各种不同的材料和表面。
FSS 310 具有 310 mm 的巨大扫描区域,在标准应用中可在 10 秒内检查 12 英寸晶圆的 TTV、弯曲、翘曲和孔洞,每小时可生产 300 多片晶圆(包括处理时间)。一体扫描系统使得短旋转运动取代长路径的线性运动,大大减少了测量时间,并且无需借助精密轴。

视野范围内扫描测量,可快速测多个位置 TSV,结构简单。

如下是使用普雷茨特传感器测量到的 TSV 从中心到四周的数据信息:


