BGA (Ball Grid Array Package) 球栅阵列封装是一种高密度、可靠性较高且散热性能优越的电子元器件封装技术。它通过球形焊点连接芯片和印刷电路板,广泛应用于现代电子产品中,特别适合集成度高、功耗大的芯片,如微处理器和图形芯片等高性能集成电路。随着芯片尺寸的减小及功能需求的增加,芯片对锡球数量、球径、高度及共面度等指标要求日趋严格。

马尔3D光学轮廓仪
– MarSurf CL Select
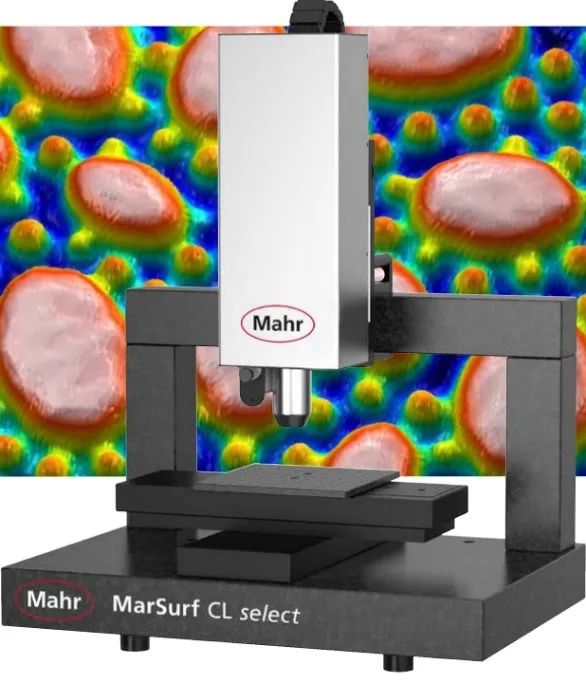
• 基于线共聚焦技术的非接触式测量
• 大型表面3D快速测量
• 全电动轴CNC控制
• 出色的高动态范围和精度
• 可达亚微米级的Z向分辨率
• 可达微米级的横向分辨率
• 操作简单方便,可实现全自动化检测
– 在BGA球中的测量参数



BGA球数量,高度和球径等的测量